
| 研究設備(プロセス系) | ||
| 有機金属気相結晶成長装置(OMVPE) | ||
 |
||
| 光デバイスの性能は元基板(ウエハ)の品質に大きく左右されます。本研究室ではGaInAsP、AlGaInAsなどの化合物半導体結晶を、有機金属気相成長装置(OMVPE)を用いて成長しています。 | ||
| 電子線露光描画装置(EB) | ||
 |
||
| 電子ビームを放射し、計算機制御により任意形状のパターンを作製することができます。加速電圧50kV、ビーム電流10pAのときビーム径を5nmまで集束することができます。本研究室ではこの装置を用いて約20nmの量子細線レーザや、DFBレーザなどの回折格子の微細加工用のマスクの作製を行っています。 | ||
| プラズマCVD装置 | ||
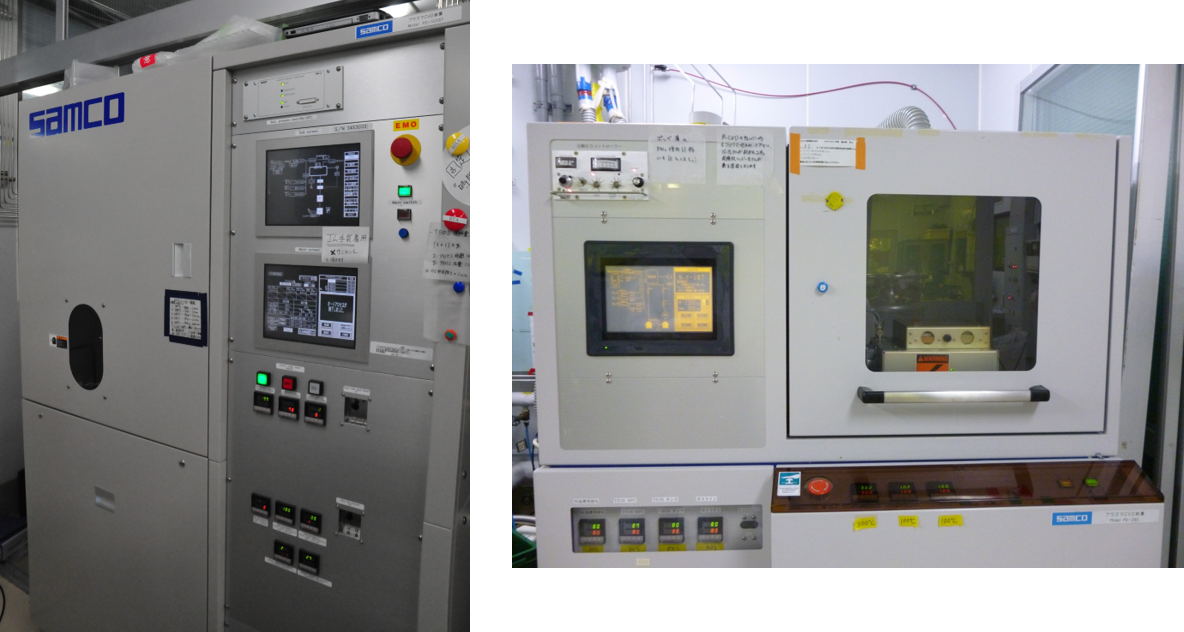 |
||
| プラズマを用いたCVD装置です。CVD (Chemical Vapor Deposition)の略で、原料となる元素を含んだ化合物をプラズマで分解して化学反応を起こし、加熱された基板表面に高純度の膜を形成する手段のことです。我々の研究室ではSiを含む原料ガスとO2を流し、プラズマを立てて基板上にSiO2を成膜しています。SiO2は絶縁膜やマスクとして用いられます。 | ||
| 反応性イオンエッチング装置(RIE) | ||
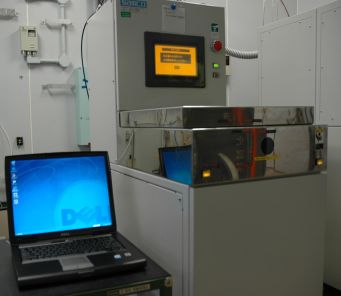 |
||
| RIE: Reactive Ion Etching 全自動の反応性イオンエッチング装置です。パターン形状の制御性・再現性、及びパターンのエッチング寸法制度が高く、メタンによる低損傷加工が可能になり、ナノオーダーの微細加工ができるようになりました。 |
||
| 誘導結合プラズマエッチング装置(ICP) | ||
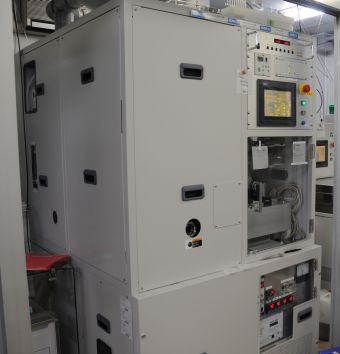 |
||
| ICP: Inductively Coupled Plasma 誘導結合プラズマ方式により高密度のイオンを生成し、各種半導体材料を高速に異方性エッチングを行うことが可能です。 |
電子ビーム蒸着装置(E-gun) | |
 |
||
| 金属を蒸着する装置です。 電子銃(Electron-gun)を用いて金属にエネルギーを与え、金属薄膜を成膜します。 |
||
| X線回折装置 | ||
 |
||
| XRD: X-ray diffraction 成膜された半導体ウェハの層構造を解析する装置です。 X線の反射スペクトルを測定し、成膜された層の状態を推定します。 |
||
| 表面活性化ウエハ接合装置 | ||
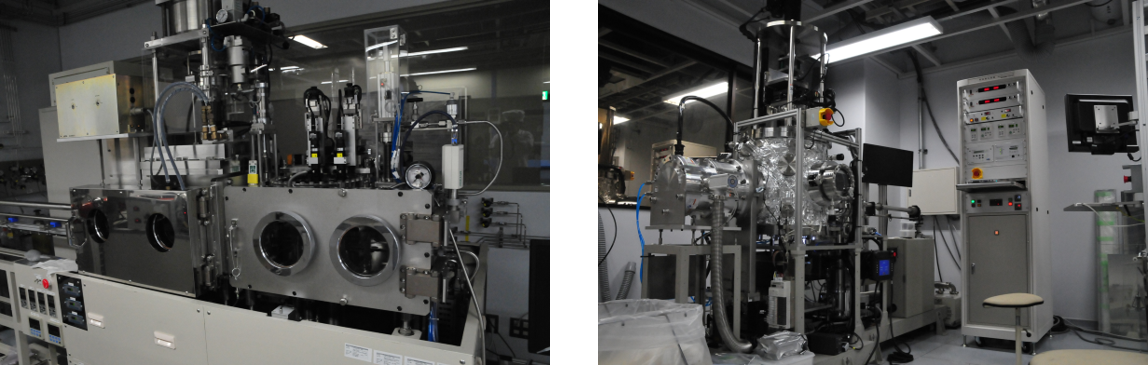 |
||
| Plasma Activated Bonding・Surface Activated Bonding 2枚の異なるウェハを接合する装置です。 当研究室では主にIII-V族化合物半導体ウェハとSiウェハの接合に用いています。 真空チャンバー内でプラズマやFAB(Fast Atom Beam)によりウェハ表面を活性化します。 |
||
| マスクアライナ | ||
 |
||
| フォトリソグラフィ時に用いる装置です。 ウェハ表面に製膜したレジストに、マスクパターンを転写します。 |
||
| マスクレス露光装置 | ||
 |
||
| フォトリソグラフィ時に用いる装置です。 マスクアライナと異なりマスクを用いず、直接レジストにパターンを描画します。 |
||
| マスク洗浄機 | ||
| マスクアライナで用いるマスクを洗浄する装置です。 |
||
| ウエハー洗浄機 | ||
| 特殊なブラシや超音波を用いてウェハを洗浄する装置です。 ウェハ接合の前処理などに用います。 |
||
| ナノインプリント | ||
 |
||
| フォトリソグラフィを用いず、原版を押し付けることで基板やポリマーなどにパターンを形成する装置です。 |
||
| オーブン | ||
 |
||
| レジストのベークなどに使う装置です。 |
||
| スピンコータ | ||
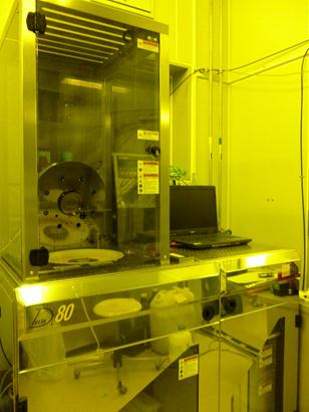 |
||
| レジストの成膜に使う装置です。 |
||
| 超音波洗浄機 | ||
| 超音波振動を用いて洗浄する装置です。 |
||
| 原子層堆積装置 | ||
 |
||
| ALD: Atomic Layer Deposition ウェハ表面に原子層を1層ずつ製膜できる装置です。 繰り返すことで、層数を増やすことが出来ます。 |
||
| 高速熱処理装置(RTA) | ||
| RTA: Rapid Thermal Annealing ウェハを急速に高温度に加熱できる装置です。 金属と半導体の接触抵抗を下げる際などに使用します。 |
||
| スパッタ成膜装置 | ||
| 誘電体などを成膜させる装置です。 加速させたイオンをターゲットにあて、ターゲットから飛んだ材料がウェハに付着し、成膜されます。 |
||
| 恒温恒湿槽 | ||
| デバイスの信頼性を測るための、温度と湿度を一定に保つことのできる槽です。 |
||
| CMP装置 | ||
| CMP: Chemical Mechanical Polishing 化学研磨剤と研磨パッドにより、ウエハの表面を平坦化することができる装置です。 |
||
| スクライバー | ||
| コメント |
||
| ウエハブレイカー | ||
| コメント |
||
| 酸化炉 | ||
| 水蒸気酸化を行うことができる装置です。 |
||
| ダイシングソー | ||
| 厚膜のチップを切り出す装置です。 強度の高いウェハを高速回転する刃を用いて切ることができます。 |
||
| 研究設備(観察系) | ||
| 光学顕微鏡 | ||
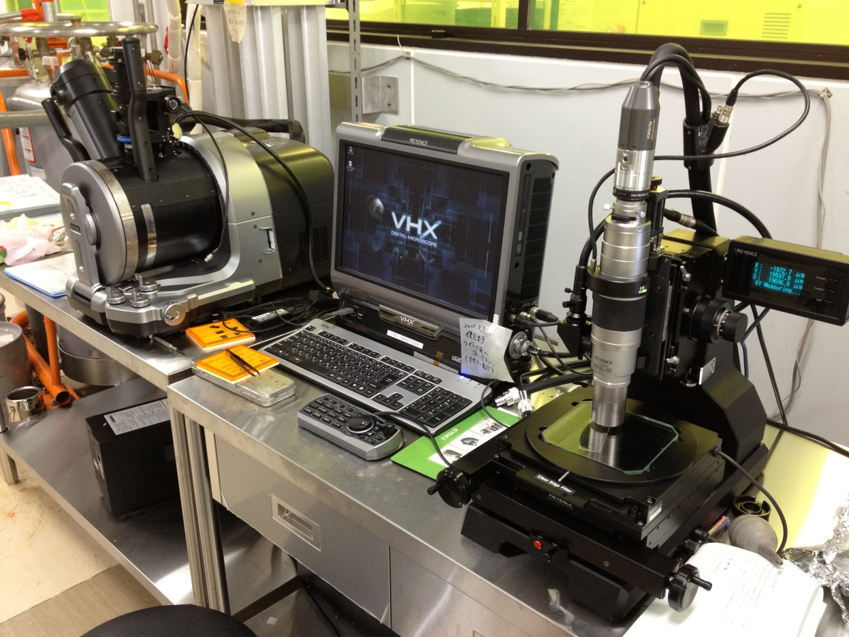 |
||
| ウェハ表面を観察する装置です。 |
||
| 走査型電子顕微鏡(SEM) | ||
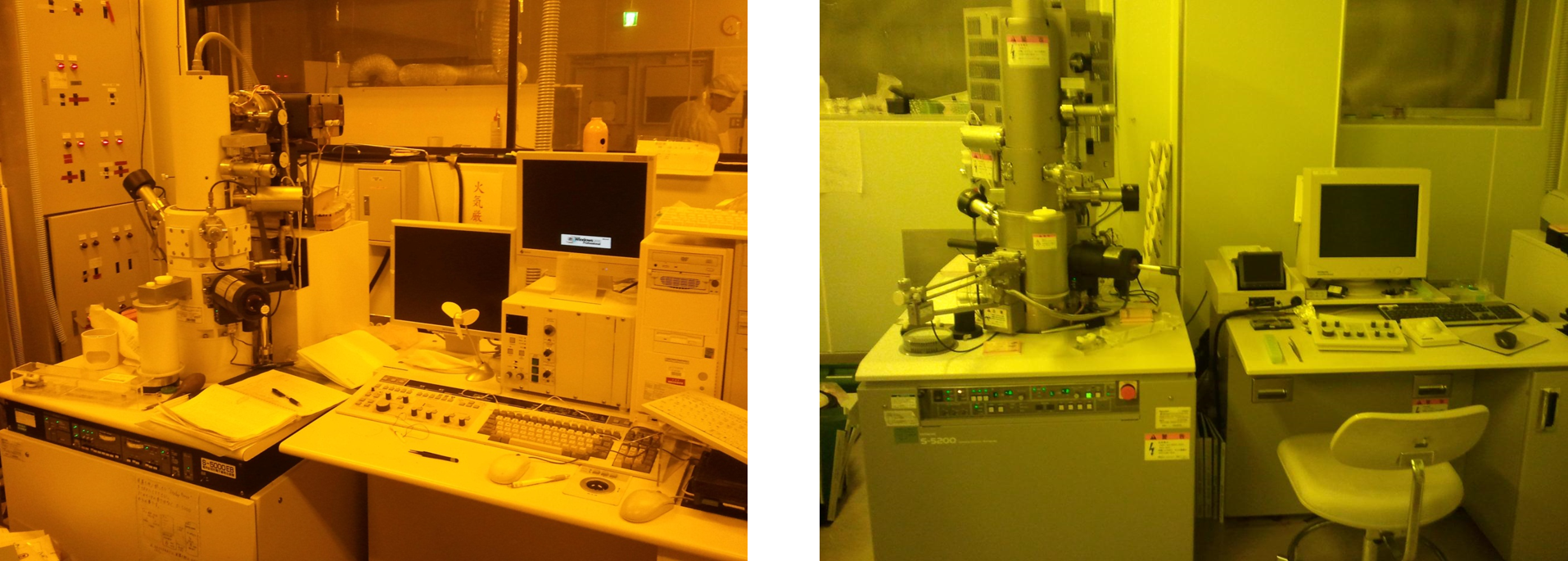 |
||
| SEM: Scanning Electron Microscope 物体に電子銃を当て、その二次電子を検出し、像として映し出す装置です。 ナノメートルオーダの微細な構造を観察する際に使用します。 |
||
| FIB-SEMデュアルビーム加工観察装置 | ||
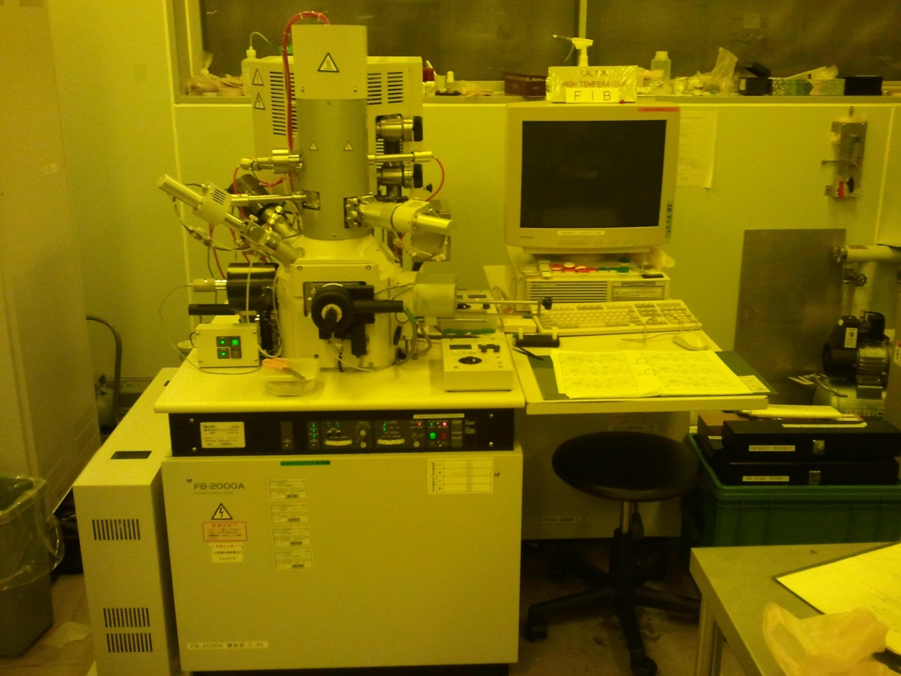 |
||
| FIB(Focused Ion Beam)とSEM(Scanning Electron Microscope)を一体化した装置です。 FIBで加工した試料をそのままSEMで観察することが出来ます。 |
||
| 研究設備(測定系) | ||
| Bartester | ||
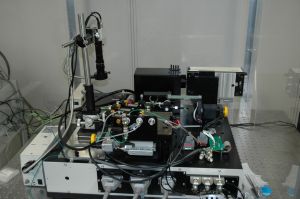 |
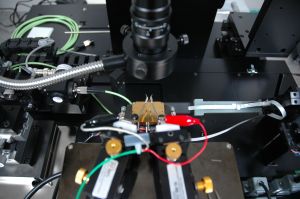 |
|
| バー状にした複数の素子を自動的に測定することができる装置です。電流-光、電流-電圧特性だけでなく温度特性、スペクトル、遠視野像、近視野像、偏光といったレーザ特性を自動的に測定することができます。 | ||
| 導波路測定装置 | ||
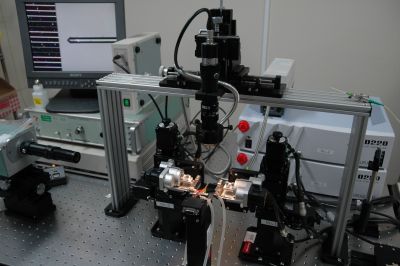 |
||
| 波長可変レーザから受光素子に光先球ファイバを用いて光入力を行い、 光ファイバと導波路の自動調芯や偏波コントローラによる偏波の制御を行うことができます。 また、赤外線カメラで導波路伝搬光を確認することができます。 長さの異なる導波路に対して入出力比を測定し、単位長さ辺りの損失を算出します。 | ||
| 高速変調測定装置 | ||
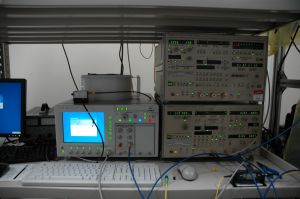 |
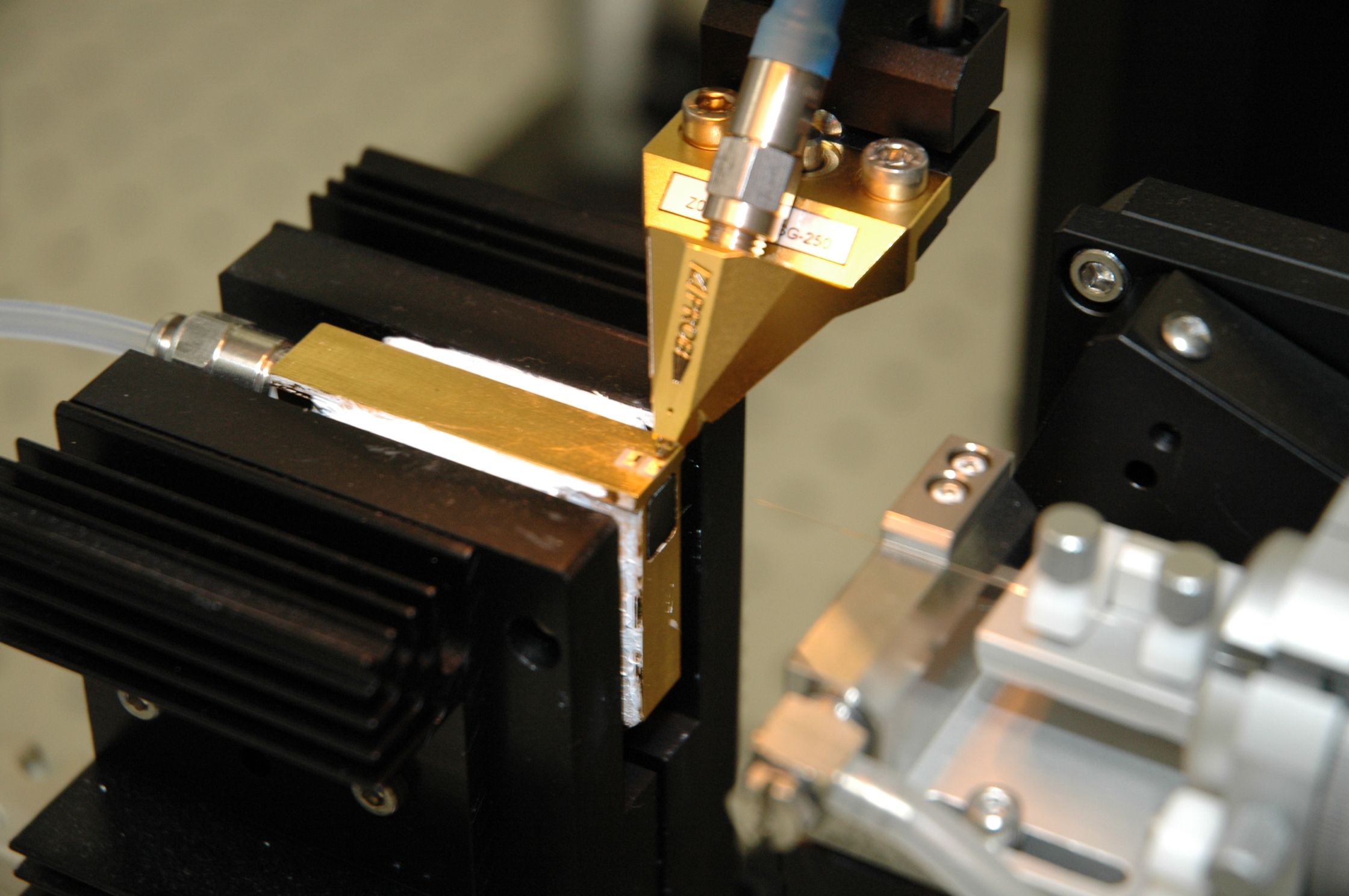 |
|
| 半導体レーザまたは外部変調器に高速信号を入力し、変調した光信号の品質を評価する測定系です。写真(左)の装置は任意の高速信号を生成するパルスパターンジェネレータ(写真の10Gbpsのほかに>50Gbpsも保有)、波形を観察できるサンプリングオシロスコープ、ビット誤り率測定装置です。その他、ネットワークアナライザやRIN測定装置などを保有しています。写真(右)では高速信号向けのプローブとファイバ調芯装置を用いて半導体レーザを直接変調する様子が写っています。 | ||
| 顕微PL装置 | ||
| 励起光源(波長980nm)を用いて半導体レーザや積層構造基板にキャリアを励起し、半導体結晶の組成・品質評価やレーザ発振動作を行っております。円形ビームスポットの顕微PLのほか、レーザの励起に適したスポットサイズ300μm×10μm (設計値)の顕微PLを使用しています。 | ||
| 任意波形発生器(AWG) | ||
| 信号波形発生器です。レーザの変調応答の測定用信号源として使用します。任意波形発生器では、従来の信号発生器では発生できないような波形でも、プログラムにより簡単に発生することができます。 | ||
| CV測定装置 | ||
| 半導体のドーピング濃度などを測る装置です。 電圧をかけると、空乏化する原理を利用して測定します。 |
||
| 反射膜厚計 | ||
| 薄膜の膜厚を測定する装置です。 測定したい層の屈折率、吸収係数の波長特性を入れ込むことで正確な膜厚を得ることが出来ます。 |
||
| 研究設備(解析系) | ||
| 半導体光デバイスシミュレータ | ||
| (1)クロスライトソフトウェアインク社製の三次元半導体レーザシミュレータ PICS3D、半導体LEDシミュレータAPSYS。 | ||
| (2)シノプシス社製のPhotonic Component Design Suite。 | ||
| (3)オプトデザイン社製のPhotonDesign。 | ||
| 研究設備(設計系) | ||
| (1)オートデスク社製のAutocad。 | ||
| (2)Genisys社製のLayout Beamer、Lab、Tracer。 | ||
