| 利用装置 |
設備ID |
装置の特長及び仕様 |
クリーンルーム内扱い |
装置写真 |
公開事業利用 |
自主事業(非公開) |
| 技術代行及び技術補助 |
装置利用及び共同研究 |
技術代行 |
装置利用 |
| 電子ビーム露光装置(JEOL JBX-8100) |
IT-038 |
スポットビーム、ベクタースキャン方式。 ビーム径3nm以下(100kV)、最小線幅8nm。つなぎ精度:仕様20nm/実測7.6nm(フィールドサイズ1000um)、重ね合わせ精度:仕様20nm/9.8nm(フィールドサイズ1000um)試料最大150㎜φウエーハまで 不定形も可能
JEOL01,51,52などの日本電子製電子ビーム露光用パターンデータファイルが入出力可能。各露光基板形状に基づいたモンテカルロシミュレーションによって点拡がり関数(PSF)を導出でき、得られたPSFに基づく近接効果補正が可能なソフトウェア(GenISys Beamer)を含む。 |
〇 |
 |
10,600 |
8,200 |
40,800 |
18,800 |
| 露光時間1時間を超えるものの時間当たり超過額 |
|
|
〇 |
|
2,800 |
2,800 |
7,800 |
7,800 |
| マスクレス露光装置 大日本科研 MX-1205 |
IT-003 |
DMDによるパターン生成露光、100mm角露光サイズ、最小線幅0.8um、線幅精度0.1um、アライメント精度±0.15um データ取り込み機能 |
〇 |
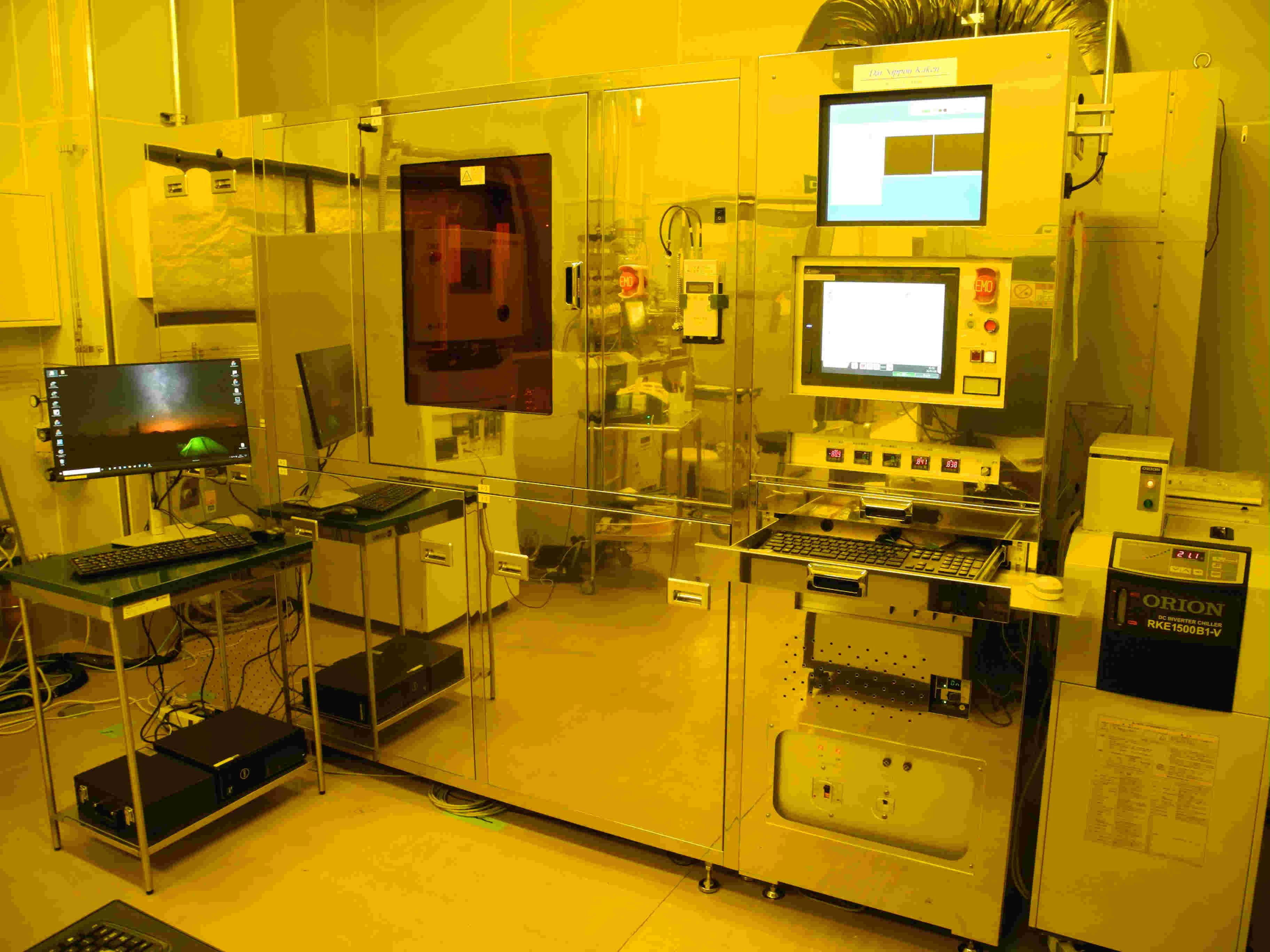 |
12,800 |
3,300 |
54,600 |
42,900 |
| マスクレス露光装置 大日本科研 MX-1204 |
IT-004 |
DMDによるパターン生成露光、150mm角露光サイズ、最小線幅2um、線幅精度0.1um、アライメント精度±0.15um |
〇 |
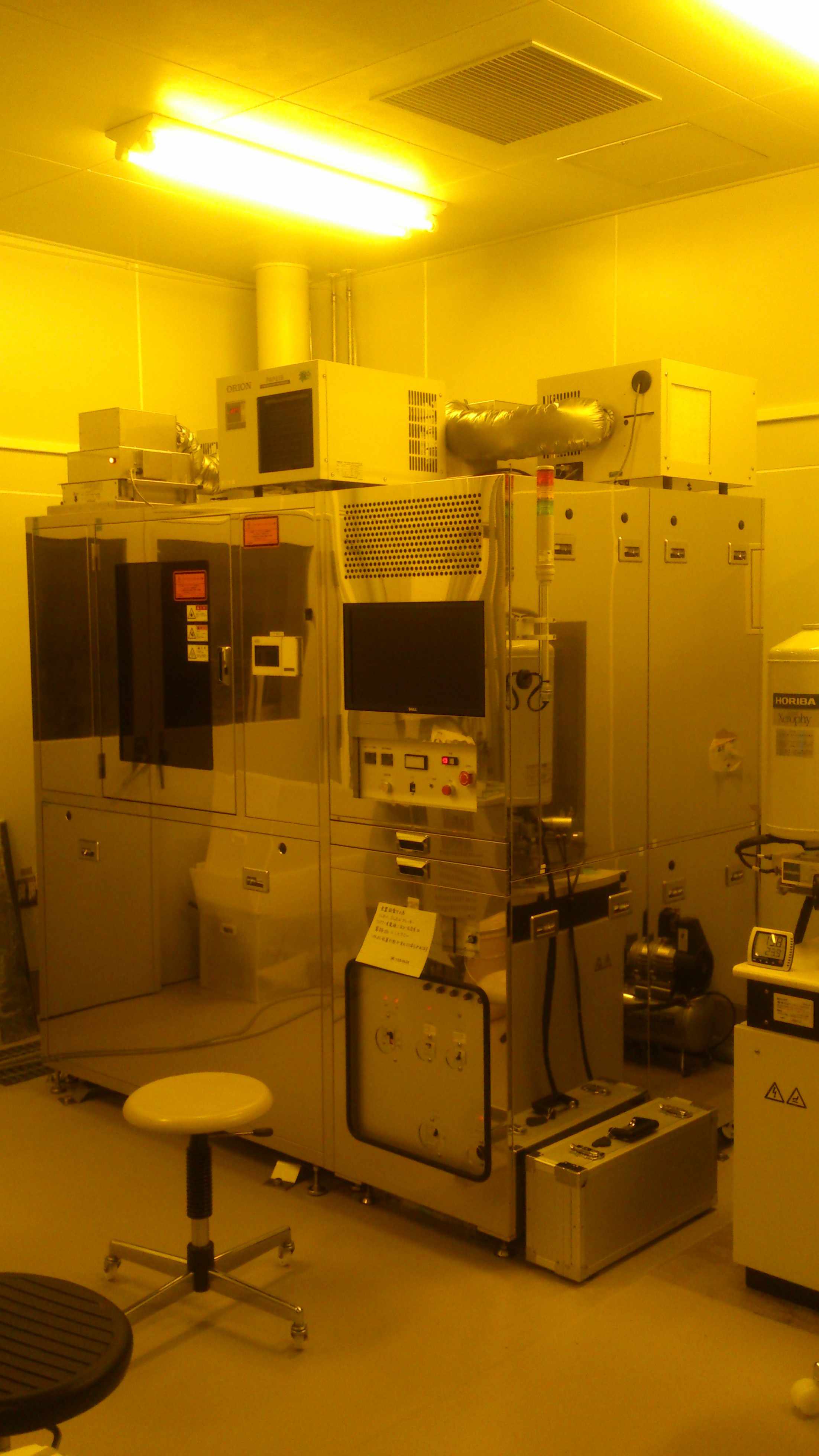 |
12,800 |
3,300 |
54,600 |
42,900 |
| コンタクト光学露光装置 Su?ss MA-8 |
IT-005 |
・アシスト機能装備、TSA/BSA装備
・表面アライメント制度 TSA:±0.25um以下 BSA:±1.00um以下
・露光解像度 0.5um
・対応基板 小片~直径2inch ウェ |
〇 |
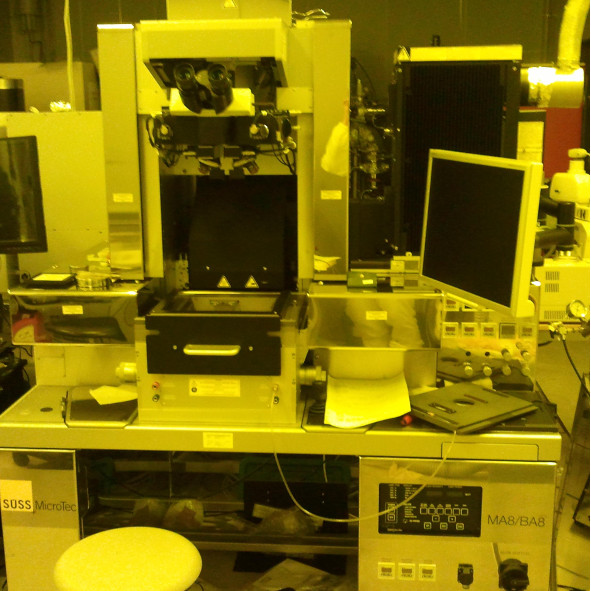 |
12,800 |
3,300 |
22,700 |
11,000 |
| 走査型電子顕微鏡 日立 S5200 |
IT-006 |
高解像度用インレンズ式高解像度用インレンズ式 加速電圧1kV~30kV 分解能0.5nm(30kV)~1.7nm(1kV) 倍率X100~X2000K STEMモード可 |
|
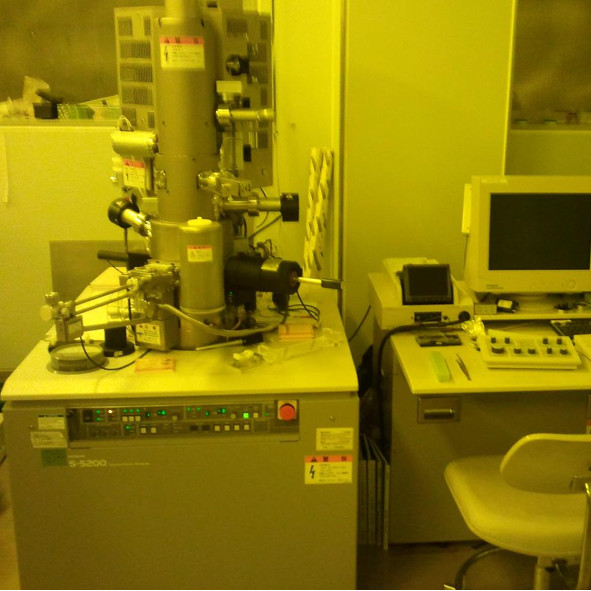 |
14,300 |
4,900 |
48,000 |
36,300 |
| 走査型電子顕微鏡 日立 S4500 |
IT-007 |
電界放出型 ・冷陰極電界放出型電子銃 ・分解能:1.5 nm (加速電圧 15 kV WD=4mm) 4.0 nm (加速電圧1 kV WD=3mm) ・試料サイス:最大50 mm (直径) |
|
 |
14,300 |
4,900 |
48,000 |
36,300 |
| 3連Eガン蒸着装置 Ulvac EX-300 |
IT-008 |
300mm対応 高速排気 |
〇 |
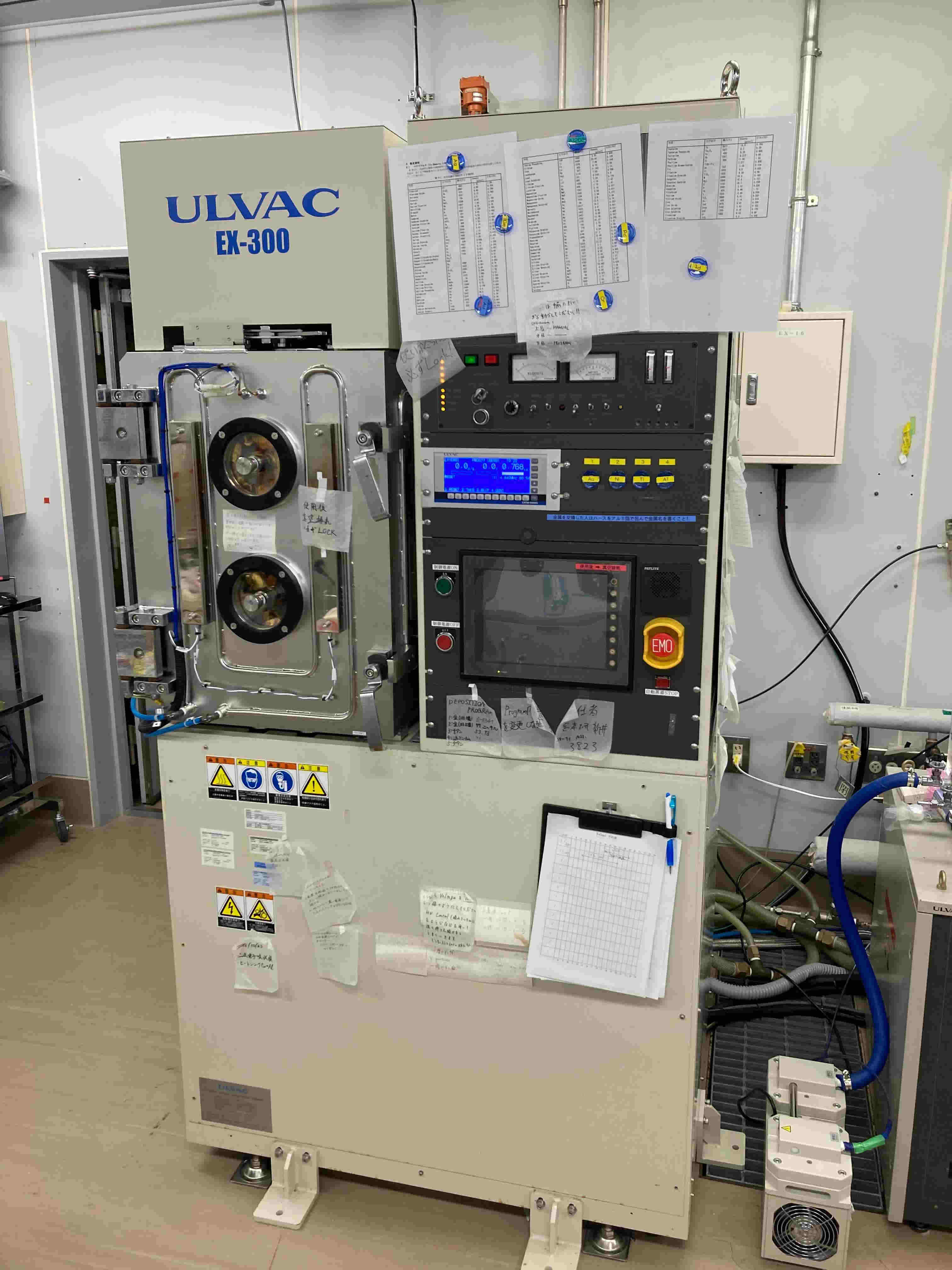 |
25,500 |
13,500 |
50,700 |
35,800 |
| 高真空Eガン蒸着装置 エイコーエンジニアリング 特注品 |
IT-009 |
ロードロックチャンバ付 6連E-gun 6kW 3連EBガン×2 到達真空度: 5e-8Torr以下 基板サイズ: 20mm角まで 蒸着原材料: Ti,Pd,Ni,Cr,Au |
〇 |
 |
25,500 |
13,500 |
50,700 |
35,800 |
| 有機金属気相成長装置(日本酸素製 HR-3246) |
IT-010 |
InP用 ・ウェハトレイ:石英製2インチウェハトレイ ・III族材料:TEG,TMG,TMA,TMI,CBr4 ・V族材料:AsH3(100%),AsH3(1%),PH3(100%),Si2H6,C2H6Zn |
〇 |
 |
182,400 |
66,000 |
261,400 |
115,800 |
| 原子層堆積装置(Ultratech/CamnbridgeNanotech製 FijiF200) |
IT-011 |
ロードロック機構付
プラズマ式/サーマル式の両方のモードでの原子層堆積が可能。化合物半導体等のMIS構造での低界面準位密度などに実績あり。(成膜温度で揮発し、装置を汚染する可能性のある材料は禁止) 酸素源:オゾンおよび水の両方の利用が可能 |
〇 |
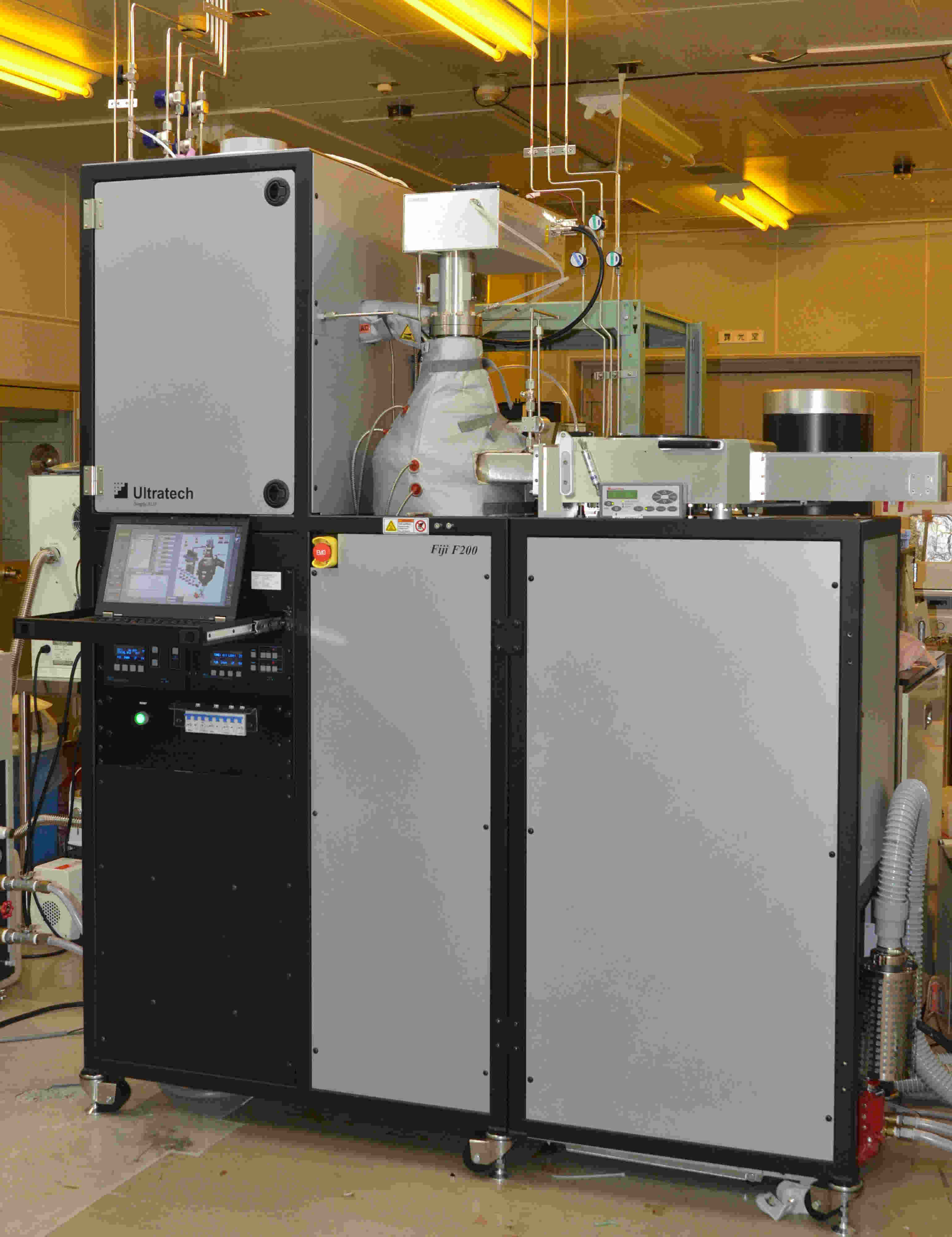 |
29,200 |
19,800 |
74,700 |
62,900 |
| リアクテブイオンエッチング装置(サムコ RIE-10NR) |
IT-012 |
・各種シリコン薄膜(Si, SiO2, poly-Si, Si3N4等)の高精度エッチング装置 ・グラフィックタッチパネルによる全自動運転 ・最大φ8インチウエハー加工可能 ・高速排気エッチング ガスの種類:CH4, H2, O2, Ar,CF4, O2 |
〇 |
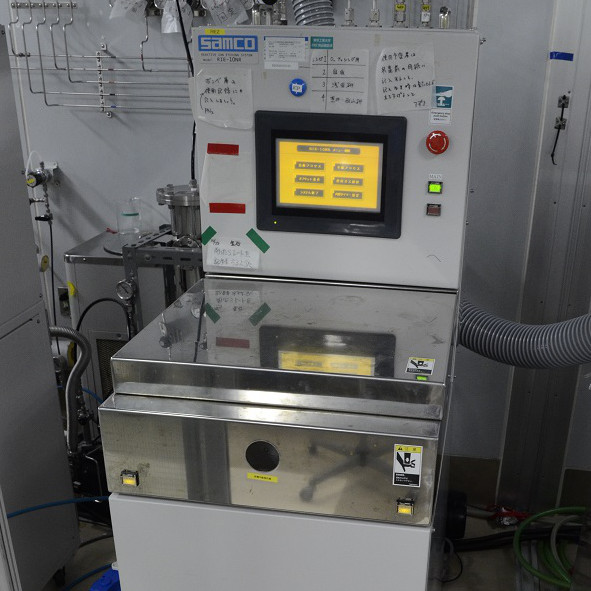 |
14,800 |
9,900 |
32,900 |
26,800 |
| ICPリアクテブイオンエッチング装置(サムコ ICP-101RF) |
IT-013 |
・使用ガス:CF4, SF6, CH4, H2, O2 ・4-inchウエハまで対応 シリコン加工関連のみに限定対応 |
〇 |
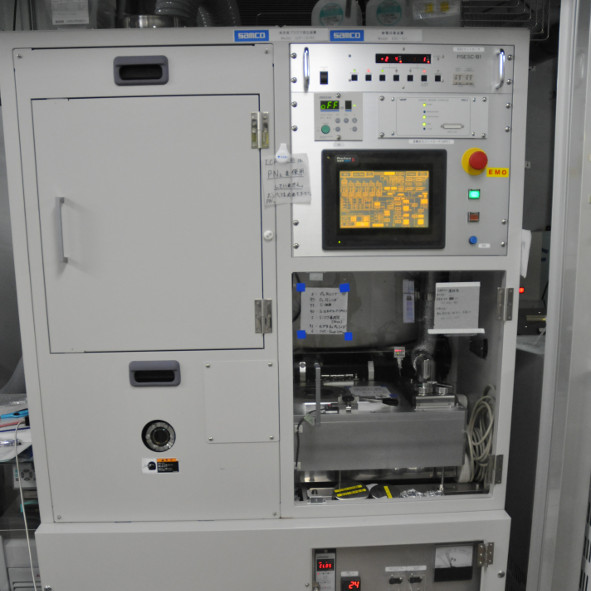 |
14,600 |
9,900 |
69,200 |
63,300 |
| ダイヤモンド用リアクテブイオンエッチング装置(サムコ ICP-400iP ) |
IT-014 |
ダイヤモンドやシリコン、SiO2などを高密度プラズマでエッチングする装置です。また、屈折率差がある材料であれば、終点検知も可能です。最大4インチ, 2インチ以下なら不定形基板の取り扱いができます。ガス種:CHF3, O2, CF4, SF6, Ar |
〇 |
 |
14,600 |
9,900 |
69,200 |
63,300 |
| SiO2 プラズマCVD 装置(サムコ PD-100ST) |
IT-015 |
使用ガス: TEOS、O2、CF4 最大3インチまで |
〇 |
 |
12,300 |
2,900 |
37,600 |
25,800 |
| SiN/a-SiプラズマCVD 装置( 住友精密 Multiplex-CVD ) |
IT-016 |
シリコン窒化膜/アモルファスシリコンの成膜 4インチ定形、もしくは2インチ以下の不定形 |
〇 |
 |
71,400 |
63,400 |
146,200 |
136,200 |
| スパッタ成膜装置(金属用)ケーサイエンス KS-702-KM |
IT-017 |
ゲージコントローラ、CDGコントローラ装備 ・膜厚計装備 ・スパッタコントローラ装備 ・Ti, W, TiW ロードロック付き装置 |
〇 |
 |
24,200 |
11,300 |
48,400 |
32,200 |
| スパッタ成膜装置(絶縁膜用)ケーサイエンス KS-702-KM |
IT-018 |
ゲージコントローラ、CDGコントローラ装備 ・膜厚計装備 ・スパッタコントローラ装備 ・SiN、Ta2O3、SiO2 最大2インチ程度まで |
〇 |
 |
24,200 |
11,300 |
48,400 |
32,200 |
| 基板貼付け装置 (アユミ工業 VE-07-18) |
IT-019 |
・対応基板サイズ:2インチウェハ,2 cm×2 cm角,3 cm×3 cm角 ・プラズマ反応ガス:Ar, N2, O2 ・最大フ?ラス?マ強 度:750W ・アライメント精度<±1.6 um ・チャンハ?ー真空 度:~10^-5 Pa ・最大加熱温度:500°C ・アライメント部 加重範囲:5~100 kgf ・加重部 加重範囲:50~1000 kgf |
〇 |
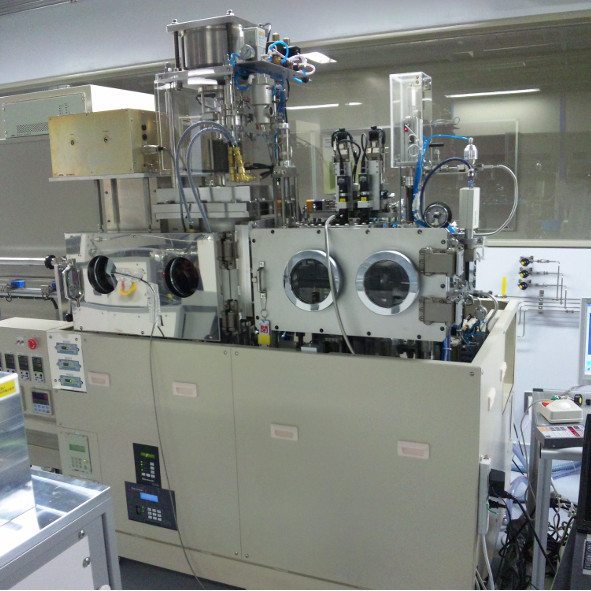 |
4,800 |
700 |
37,600 |
32,400 |
| ウェハ洗浄装置 (EVG EVG301) |
IT-020 |
・PVA製スポンジブラシ洗浄 ・メガソニック洗浄(最大振動子出力:40 W) ・対応基板サイズ:2インチウェハ/2 cm×2 cm角/3 cm×3 cm角 |
〇 |
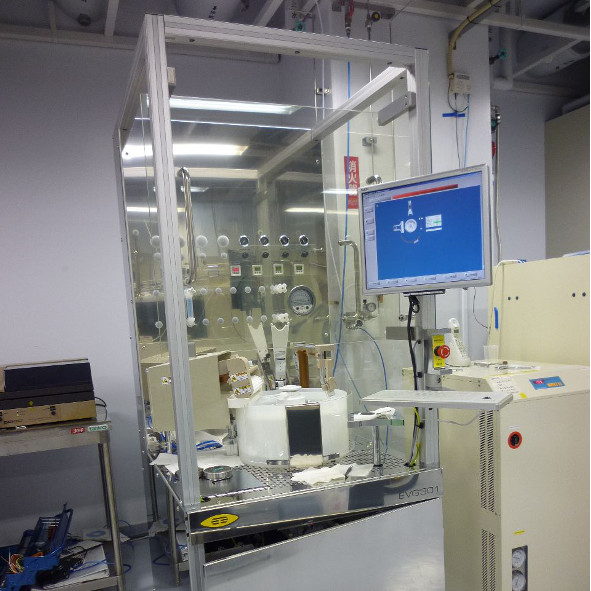 |
7,700 |
1,800 |
28,600 |
21,200 |
| C-Vプロファイラ (Bio-rad POLARON PN4400) |
IT-021 |
ワイドバンドギャップ半導体評価も可能 |
〇 |
 |
28,000 |
15,000 |
62,200 |
46,100 |
| 化合物半導体光素子用酸化炉 エピクエスト Hivox3001 |
IT-022 |
化合物半導体用AlAs酸化用 最大加熱温度500度
最大ウェハサイズ3インチ
赤外線カメラによるin-situモニタ付き |
〇 |
 |
18,400 |
9,000 |
27,700 |
16,000 |
| FIB-SEMデュアルビーム加工観察装置(JEOL製 JIB-4501)時間当たり |
IT-023 |
FIB部分 Ga 液体金属イオン源、加速電圧 1-30kV,ビーム電流最大60nA以上 SEM部分 加速電圧0.3-30kV 分解能 3nm以下 |
〇 |
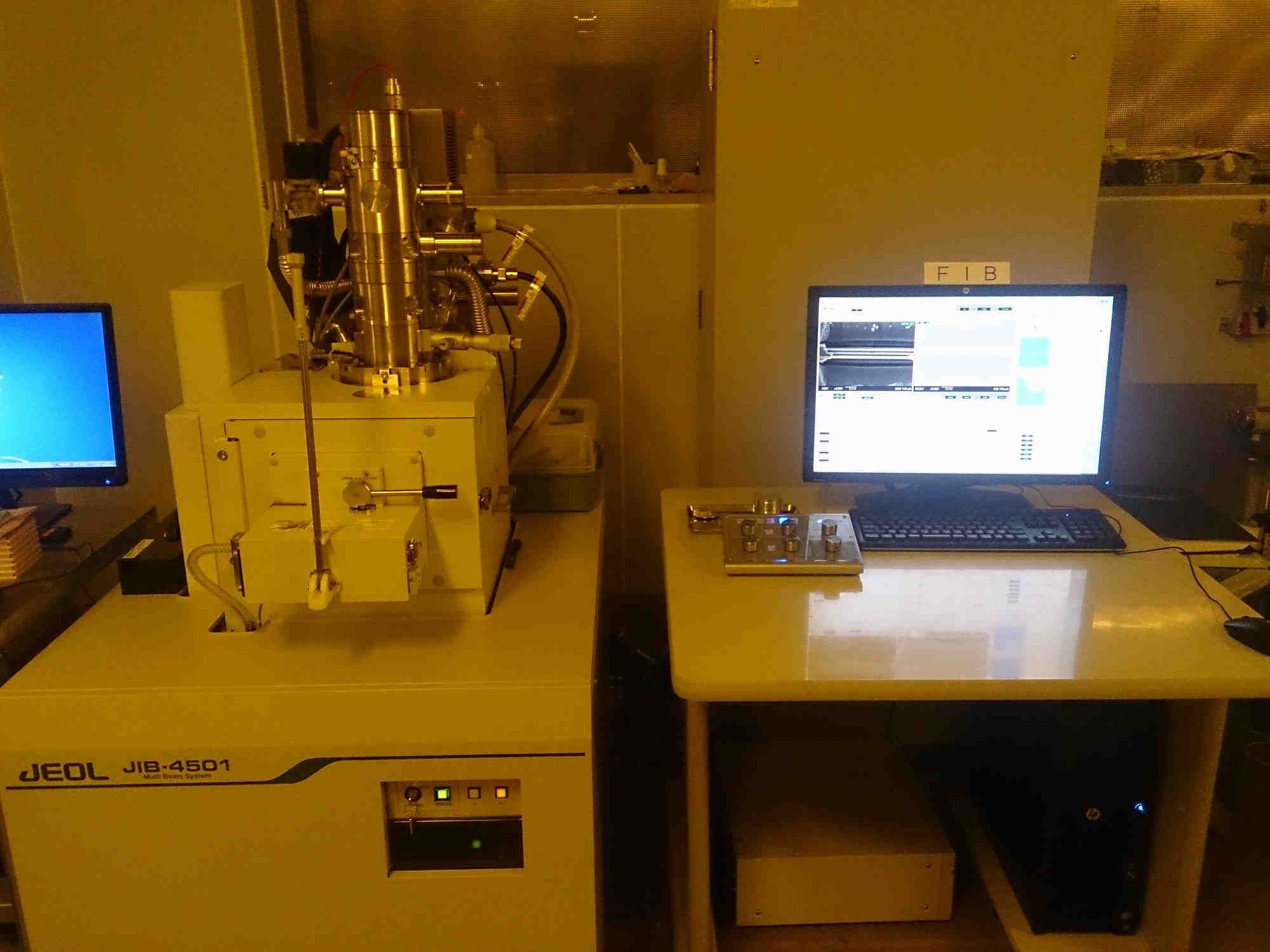 |
11,900 |
6,000 |
33,500 |
26,200 |
| ダイシングソー(ディスコ DAD322) |
IT-027 |
φ6インチ 切削可能範囲 x軸160mm y軸162m z軸32.2mm(φ2"ブレード時) UV照射装置およびウェハ拡張装置 ヒューグルエレクトロニクス HUV-0608/HS-1840(6インチダイシングフレーム(ディスコDTF2-6-1互換)設置可)によるダイシング前後処理も可能 |
〇 |
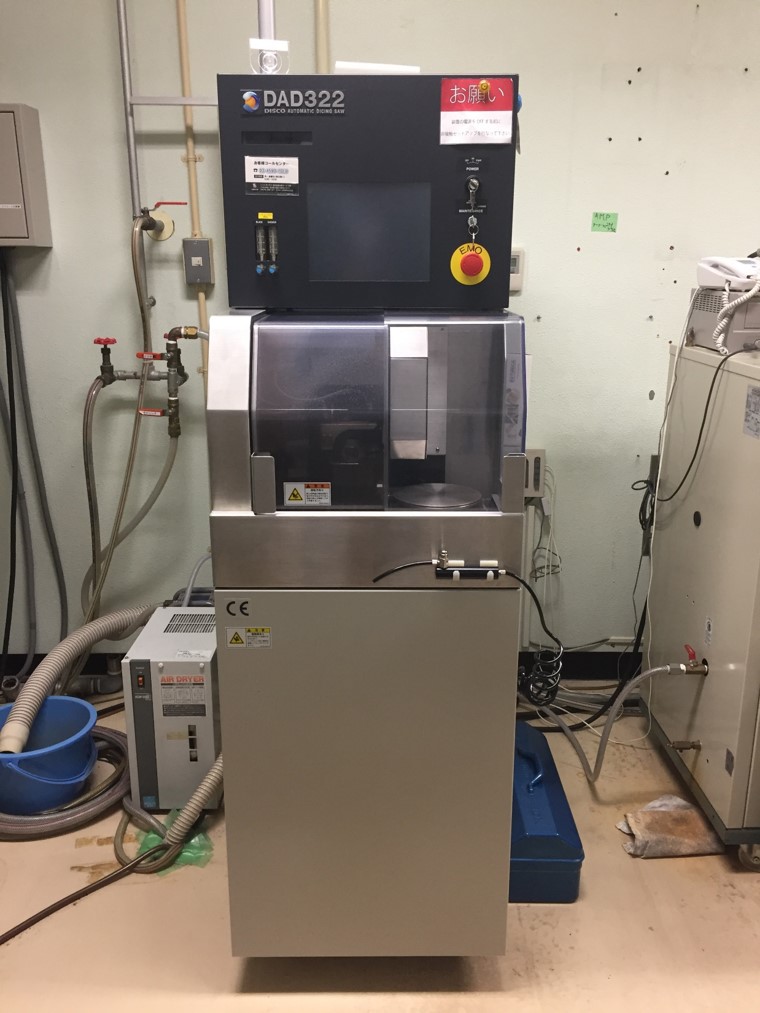 |
13,900 |
1,000 |
9,000 |
2,400 |
| スパッタ装置(対向ターゲット式) |
IT-028 |
対向ターゲット式RFスパッタリング(2元) 最大3インチまで (ただし堆積は中央の2インチ程度) |
〇 |
 |
23,400 |
11,700 |
27,900 |
21,900 |
| 薄膜評価用試料水平型X線回折装置(リガク SmartLab ) |
IT-029 |
薄膜評価用試料水平型 |
〇 |
 |
18,700 |
8,100 |
38,400 |
31,800 |
| フォトルミネッセンス測定装置(堀場顕微PL測定装置) |
IT-030 |
励起波長:640nm、1064nm、受光器:GaInAs、対物レンズ:x10(NA0.26)、x100(NA0.5) |
|
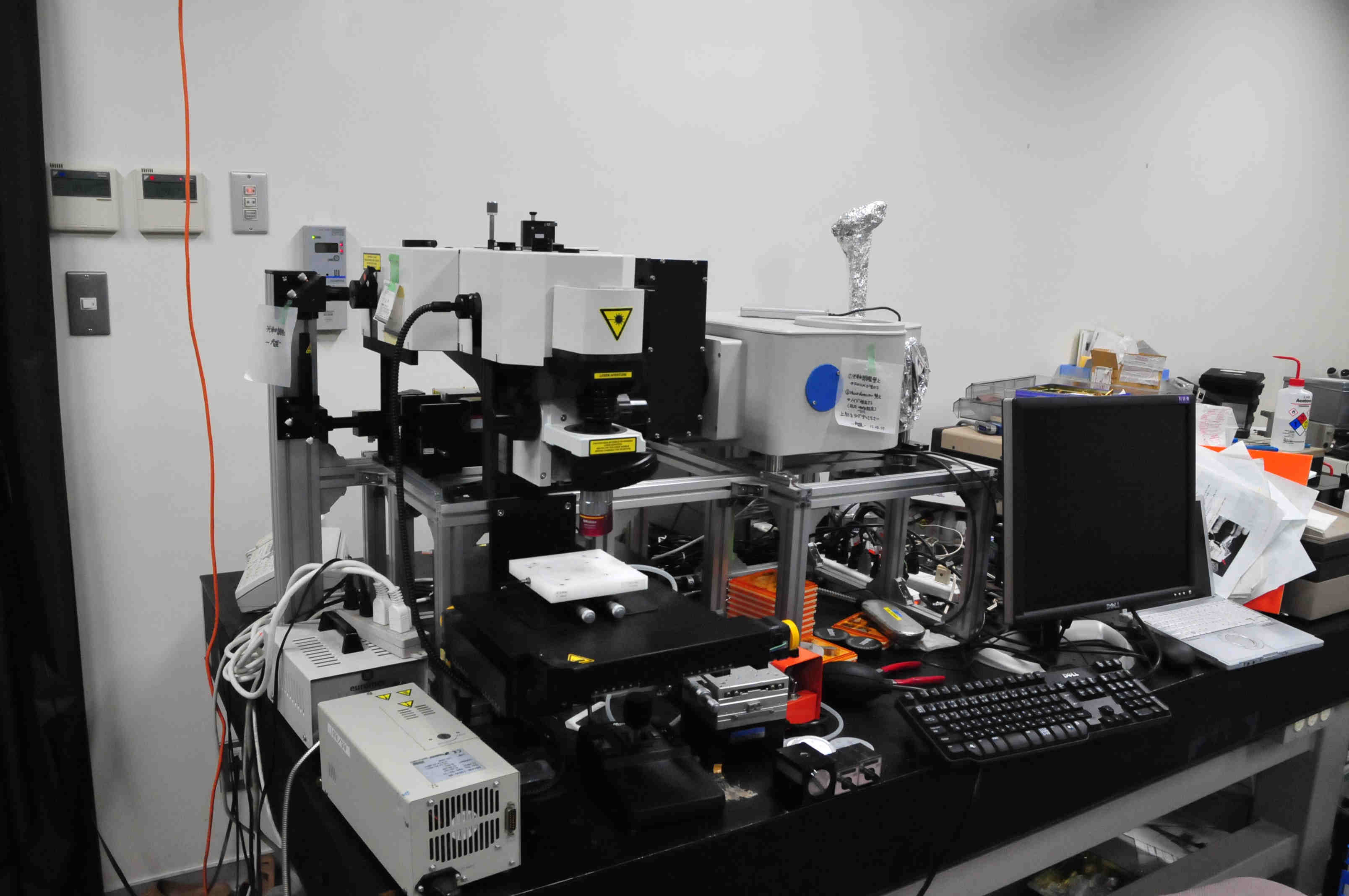 |
16,800 |
4,800 |
35,000 |
23,000 |
| 磁気光学効果評価装置 |
IT-031 |
プレサイスゲージ社製導波路調芯装置/サンテック社製波長可変光源(波長1500~1680nm)/FiberPro社製ASE光源(~20dBm)/アドバンテスト社製光スペクトラムアナライザ(波長分解能0.01nm)による光導波路試料の磁気光学効果の測定
ファラデー回転測定装置(波長1550nm、最大磁場~1.6T:面直)/ネオアーク社製磁気カー偏光顕微鏡(対物レンズ50倍、最大磁場~0.1T:面内)による薄膜試料の磁気光学効果の測定 |
| 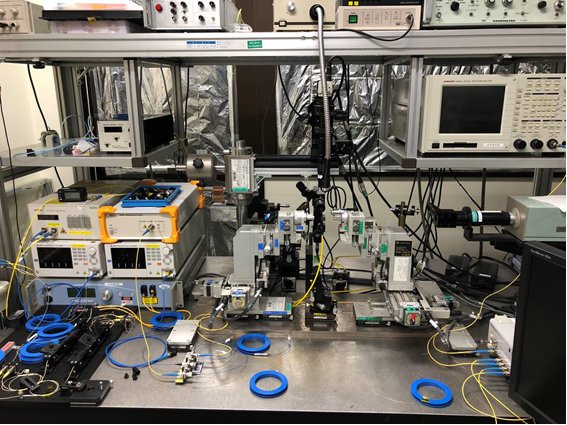 |
9,200 |
3,600 |
38,600 |
31,500 |
| 共焦点ラマン顕微鏡(WiTec alpha300R) 時間あたり |
IT-032 |
532 nm レーザー、グレーティング 600 g/mmおよび1800 g/mm(ブレーズ波長 500 nm)、空間分解能 350 nm(XY方向)および900 nm(Z方向)、対物レンズ 10倍・20倍・50倍・100倍、XYZ自動ステージによるラインスキャン・2次元マッピング・3次元マッピング |
| 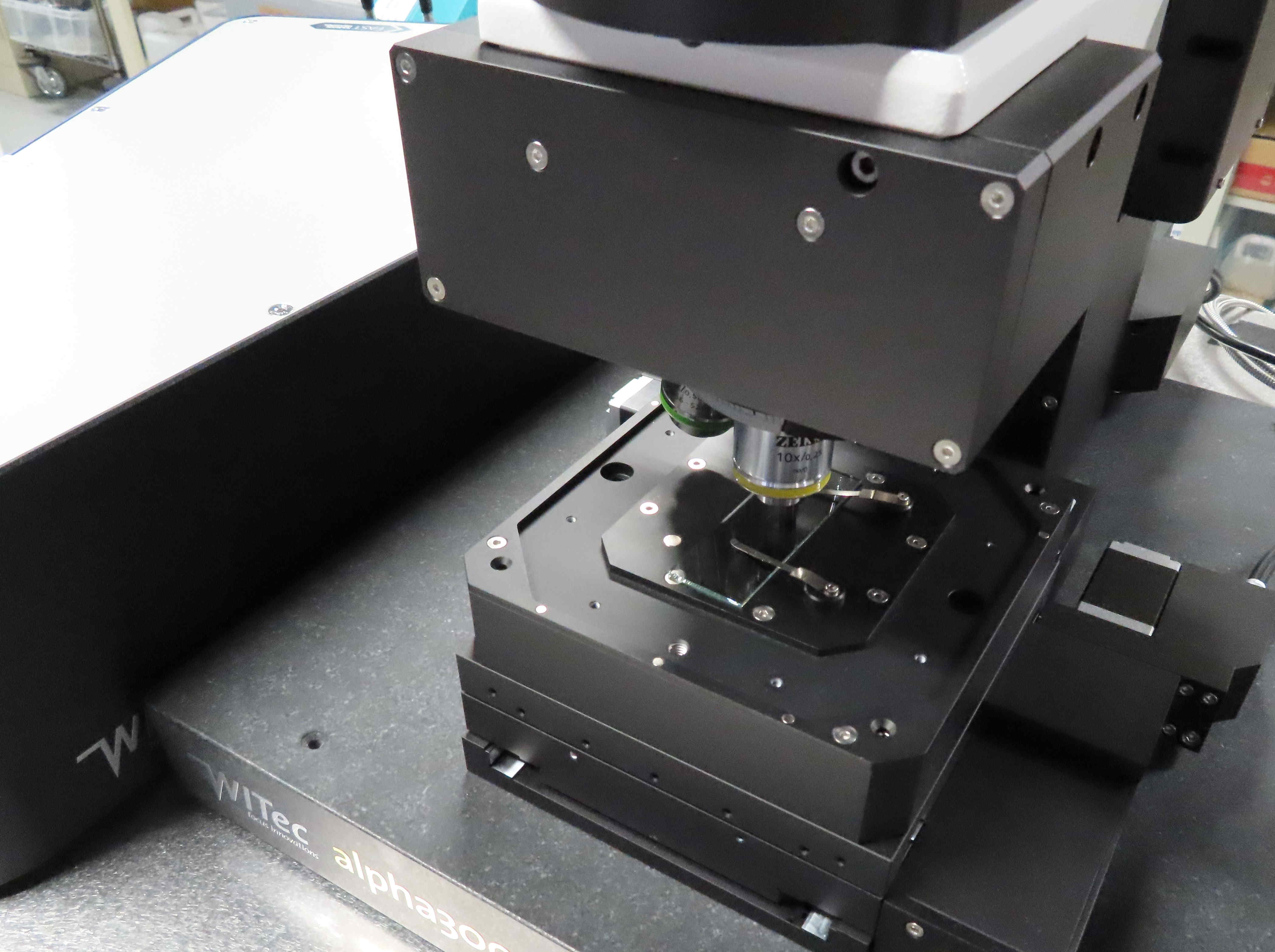 |
12,100 |
1,500 |
23,700 |
10,500 |
| マイクロ波プラズマCVD装置 |
IT-033 |
マイクロ波周波数 2.45 GHz、マイクロ波パワー 最大6 kW、水素・メタンガスによるダイヤモンド合成、窒素ガスによる不純物ドーピング、基板サイズ 50mmΦまで 窒素を添加することで、現在注目されている量子センサである窒素-空孔(NV)センタを作ることも可能です。 |
| 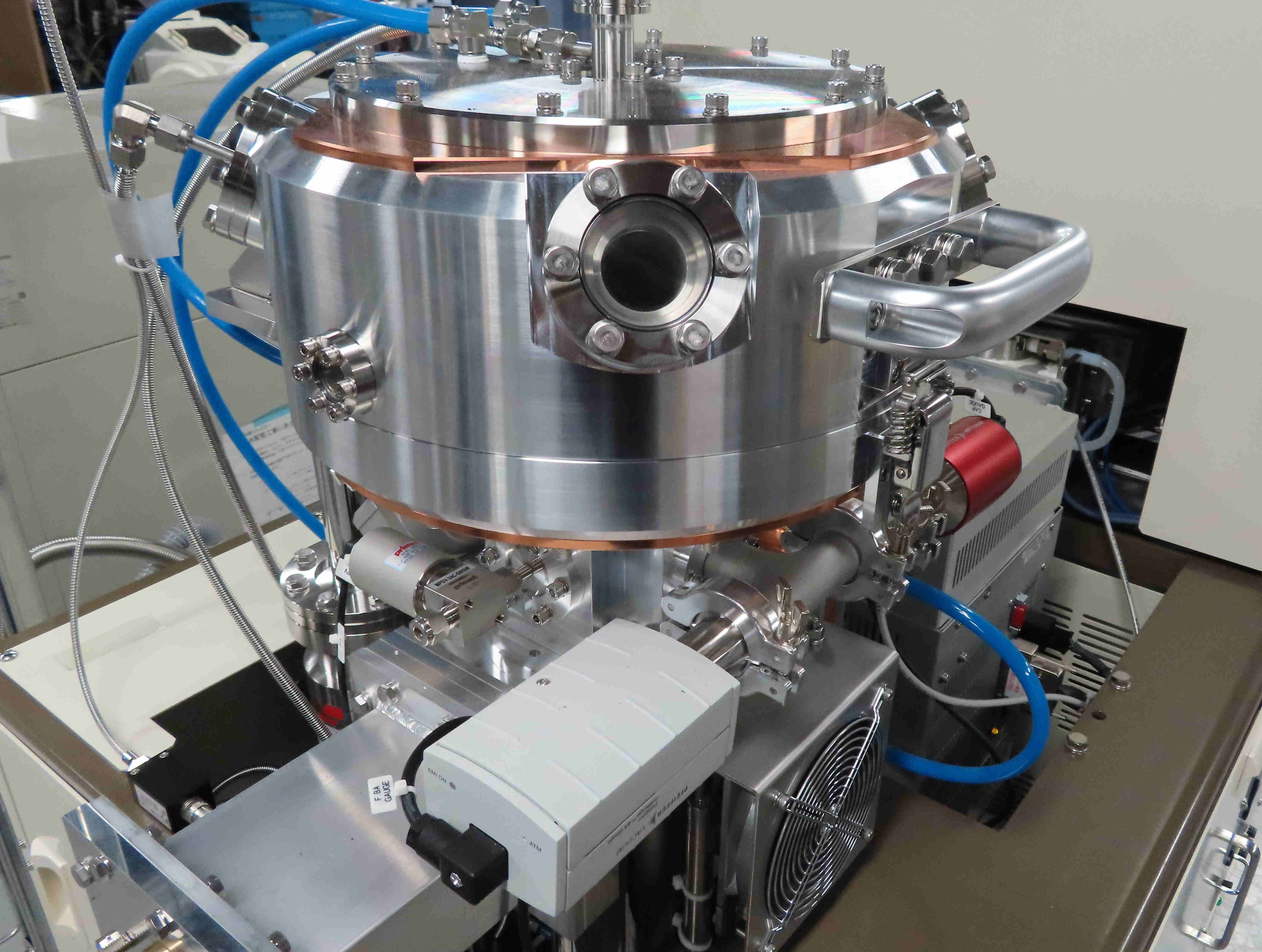 |
28,500 |
3,900 |
60,500 |
28,000 |
| クライオ共焦点顕微鏡 時間あたり |
IT-034 |
クライオスタットのプラットフォーム温度 3.4~350 K(試料温度は3.5 Kよりも上昇)、レーザ波長 514 nm、対物レンズ 50倍、光検出器 アバランシェフォトダイオードおよび分光器、XYおよびXZの2次元発光マッピング、Hanbury-Brown Twiss計測 |
|  |
18,900 |
1,300 |
32,500 |
10,500 |
| 東京エレクトロン300mm ウェハプローバ 時間あたり |
IT-035 |
150mm, 200mm, 300mmウェハ対応プローバー
多数枚自動測定対応、シリコンフォトニクス受動デバイス静特性測定 |
| 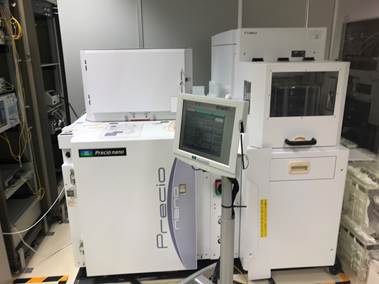 |
17,200 |
12,800 |
18,800 |
14,400 |
| FormFactor 300mm ウェハプローバ 時間あたり |
IT-036 |
チップ~ 300mmウェハ対応プローバー
単枚自動測定対応、シリコンフォトニクス受動デバイス静/動特性測定 |
| 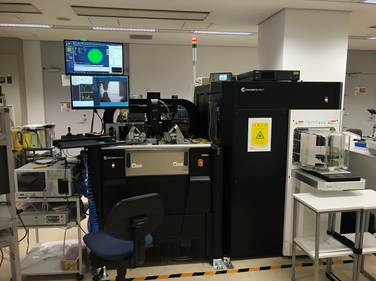 |
10,900 |
6,500 |
25,600 |
21,200 |
| UVナノインプリント露光装置 (EVG620NT) |
IT-039 |
UVによるナノインプリント露光装置。4inchまで対応。解像度限界 L/S 50nm。 |
〇 |
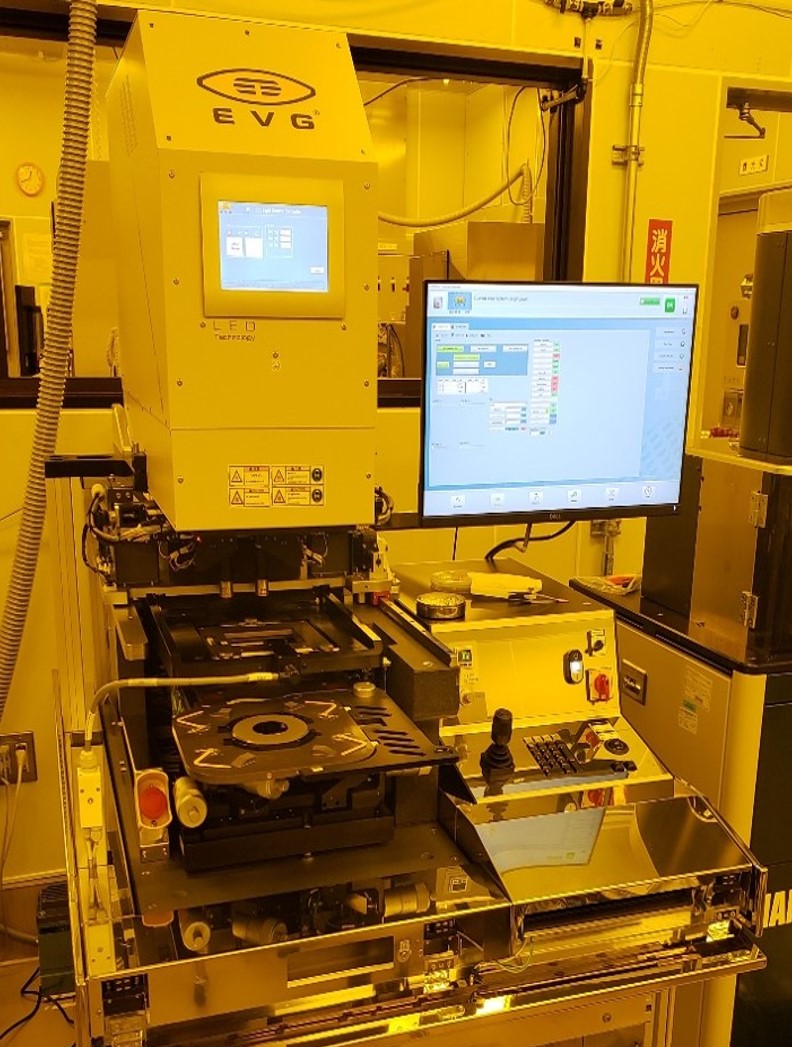 |
19,600 |
9,600 |
41,600 |
10,000 |
| クリーンルーム利用料 一日一人当たり (ただし月当たり5日以上は控除) |
IT-037 |
純水製造装置・薬品処理ドラフトチャンバー・レジスト処理装置・光学顕微鏡(デジタル含)、低真空SEM、触針式段差計などを含むクリーンルーム用設備群
・触針式段差計: Φ150mm電動ステージ > 長距離測定(最大150mm) 垂直測定レンジ(最大)327μm 垂直測定分解能(最高)0.001nm 段差測定再現性 1σ=0.4nm (1μm標準試料) 針圧範囲 0.5~50mg
・低真空SEM: レンズ:電子式超深度レンズ+光学 倍率:30-5000倍(垂直)、30-2000倍(傾斜)、50-500倍(光学) 観察像: 2次電子 試料サイス?: Φ100 mm 5軸(XYZ+傾斜+回転) 試料室200 mm ×200 mm 試料高さ 30 mm
・デジタル顕微鏡: ハイレゾリューションヘッド : 1/1.7 型 1,222万 画素 CMOSイメージセンサ 総画素 4,168 (H) × 3,062 (V) 実効画素 4,024 (H) × 3,036 (V) |
〇 |
 |
- |
3,000 |
- |
3,700 |
| 初回利用料 |
|
|
|
|
33,000 |
0 |
49,500 |
49,500 |